
Circles represent the data by Miki et al. (1975).
Full circles - InSb substrate,
Open circle - GaSb substrate.
Squares represent the data by Kawashima and Kataoka (1979).
Electron concentration no~1015÷1016 cm-3.
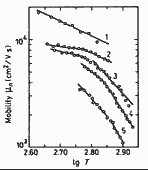
1 - x=0.10, 2 - x=0.47,
3 - x=0.70, 4 - x=0.86,
5 - x=0.91.
(Wooley and Gillett (1960))
See also Coderre and Woolley (1969).

Open circles represent measurements with a group of samples having approximately the same residual acceptor concentrations Na . Full symbols: specimens with lower residual acceptor concentrations. Solid lines represent the theoretical calculations for different values of compensating acceptor densities - either singly (Na-) or doubly (Na--) ionized.
1 - Na-=1.2·1017 cm-3 or Na--=0.4·1017 cm-3, 2 - Na-=2.85·1017 cm-3 or Na--=0.95·1017 cm-3, 3 - Na-=4.5·1017 cm-3
(Baxter et al. (1967)).

(Litwin-Staszewska et al. (1981)).

(Baranskii and Gorodnichii (1969)).

MBE technique. Carrier concentration po at 300K:
1 - 2.28·1016 cm-3;
2 - 1.9·1016 cm-3.
(Johnson et al. (1988)).

Experimental data are taken from five different papers.
(Wiley (1975)).

1 - 77 K (Filipchenko and Bolshakov (1976)).
2 - 290 K (Wiley (1975)).

(Baranskii and Gorodnichii (1969)).